哪里可以检测硅片?中析研究所检测中心提供硅片检测服务,出具的硅片检测报告支持扫码查询真伪。服务项目:元素分析、表面形貌、显微结构、结构分析、物理性能、薄膜厚度、电性能、化学成分等。实验室工程师严格按照相关标准进行实验,并且提供非标实验定制服务。
检测周期:7-15个工作日,参考周期
检测样品
单晶硅片、多晶硅片、SOI硅片、玻璃硅片、氮化硅片。
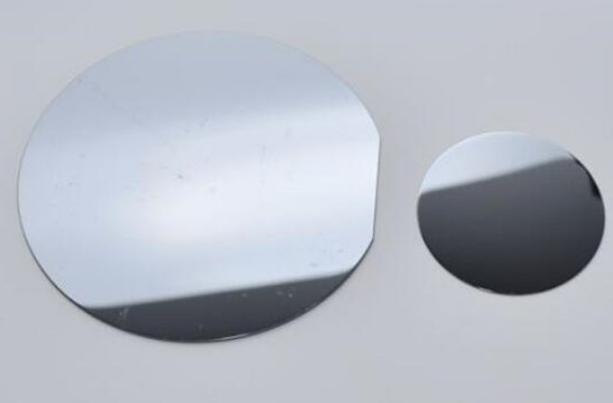
检测项目
元素分析、表面形貌、显微结构、结构分析、物理性能、薄膜厚度、电性能、化学成分。
检测方法
表面形貌和显微结构分析:扫描电子显微镜、光学显微镜。
结构分析:X射线衍射。
物理性能测试:硬度计、弹性模量测量仪。
电性能测试:电阻测试仪、载流子迁移率测量仪。
元素分析:原子吸收光谱、电感耦合等离子体发射光谱、X射线荧光光谱。
薄膜厚度测量:表面粗糙度仪、白光干涉仪。
化学成分分析:滴定法、离子色谱法。
表面清洁度测试:核磁共振、红外光谱。
检测仪器
扫描电子显微镜、原子力显微镜、光学显微镜、X射线衍射仪、电子探针微区分析仪、薄膜厚度计、电子束曝光仪、硬度计、弹性模量测量仪、红外光谱仪、电感耦合等离子体发射光谱。


检测标准
GB/T 6616-2009 半导体硅片电阻率及硅薄膜薄层电阻测试方法 非接触涡流法
GB/T 6617-2009 硅片电阻率测定 扩展电阻探针法
GB/T 6618-2009 硅片厚度和总厚度变化测试方法
GB/T 6619-2009 硅片弯曲度测试方法
GB/T 6620-2009 硅片翘曲度非接触式测试方法
GB/T 6621-2009 硅片表面平整度测试方法
GB/T 11073-2007 硅片径向电阻率变化的测量方法
GB/T 13388-2009 硅片参考面结晶学取向X射线测试方法
GB/T 14140-2009 硅片直径测量方法
GB/T 19444-2004 硅片氧沉淀特性的测定-间隙氧含量减少法





 扫一扫关注公众号
扫一扫关注公众号

